根据彭博社的最新调查,华为和中芯国际集成电路制造有限公司(SMIC)已经提交了自对准四重图形刻蚀(SAQP)技术专利,以使中芯国际实现 5 纳米半导体生产。这两家中国巨头一直在利用深紫外光(DUV)设备开发图案刻蚀技术,使中芯国际能够生产符合美国出口规则的节点,同时保持之前宣布的 7 纳米节点的工艺精度提升。
在 7 纳米工艺中,中芯国际最有可能使用自对准双图案技术(SADP)和 DUV 工具,但为了提高 5 纳米节点的密度,需要将 SAQP 提高一倍。在半导体制造过程中,光刻工具需要多次转动来蚀刻硅晶片上的设计。
特别是随着更小的节点对密度的要求越来越高,使用 DUV 工具蚀刻 10 纳米以下的设计变得越来越具有挑战性。这就是 ASML 的极紫外光 (EUV) 工具发挥作用的地方。使用 EUV,光刻打印机的波长比 DUV 小 14 倍,仅为 13.5 nm,而 ArF 浸透 DUV 系统的波长为 193 nm。
这就意味着,如果没有 EUV,中芯国际就必须寻找 SAQP 等替代方案来提高节点密度,结果会增加复杂性,并可能降低产量。例如,英特尔曾试图在其首批 10 纳米节点中使用 SAQP,以减少对 EUV 的依赖,结果造成了一系列延误和并发症,最终将英特尔本身也推向了 EUV。
虽然华为和中芯国际可能会为 SAQP 开发出更高效的解决方案,但由于普通 DUV 无法跟上半导体节点密度的不断提高,因此使用 EUV 已迫在眉睫。鉴于 ASML 无法将其 EUV 设备运到中国,据称华为正在开发自己的 EUV 设备,但可能还需要几年时间才能展示出来。
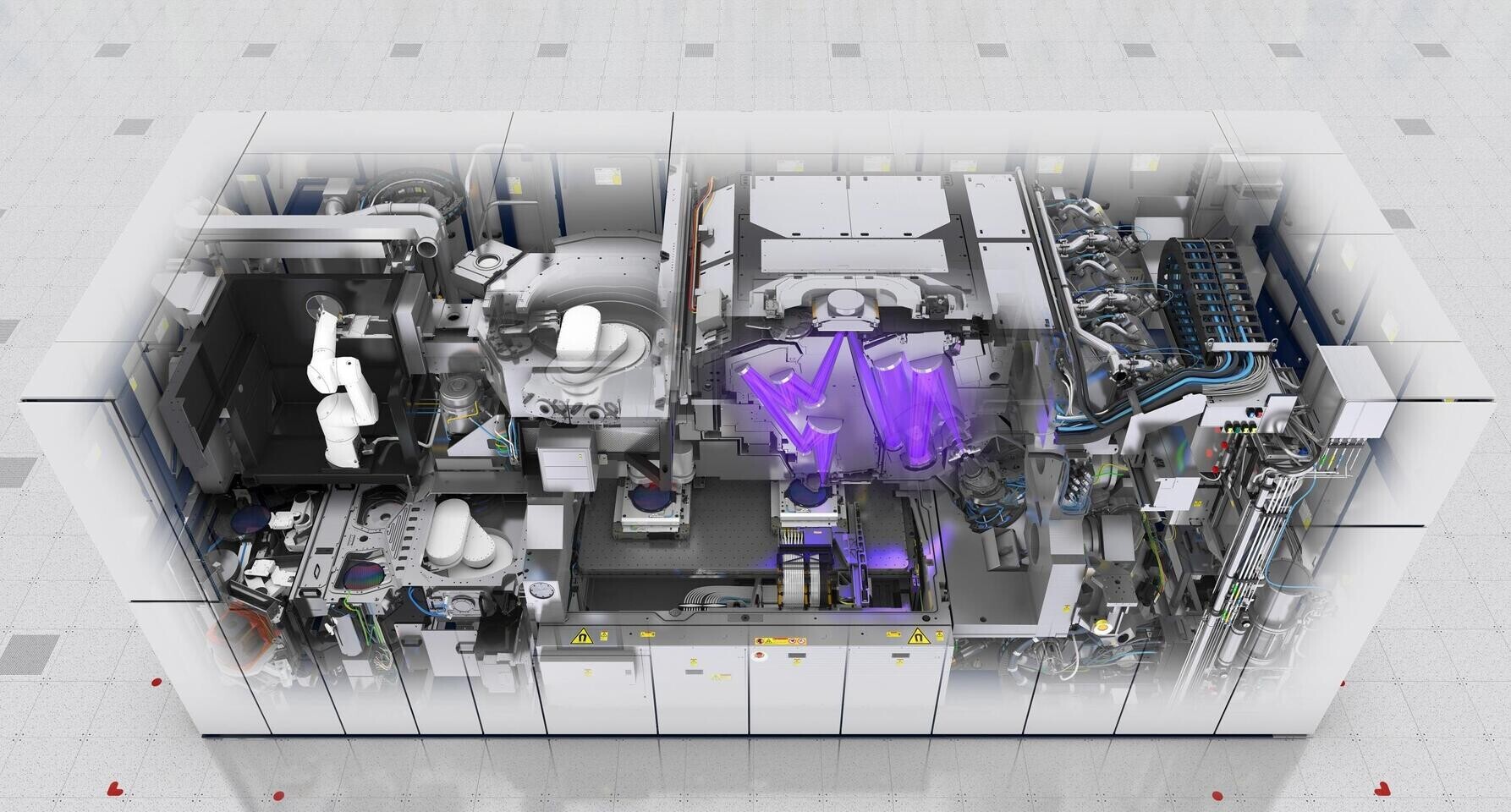
注意事项:
1、资源遇到是一堆字母与数字组合的,复制到电脑版的xunlei或BT新建下载即可。
2、度盘的资源容易失效,失效一般补不了,请理解!
3、如果支付后没有自动跳转,请等一两分钟让它自动跳转后再刷新看看,还不行的话请联系退款。
4、百家姓转换
免责声明:本站文章采用创作共用版权 CC BY-NC-ND/2.5/CN 许可协议,文章及资源均来自互联网收集,仅供用于学习和交流,请遵循相关法律法规,本站一切资源不代表本站立场!!!




